京の発明 TOWA株式会社

 昭和40年代半ばに入って半導体産業は活況を呈するようになってきた。新しい半導体製造装置を開発することによって、この分野への参入を企図していた坂東和彦は、昭和54年(1979)にマルチプランジャ成形システムを完成した。
昭和40年代半ばに入って半導体産業は活況を呈するようになってきた。新しい半導体製造装置を開発することによって、この分野への参入を企図していた坂東和彦は、昭和54年(1979)にマルチプランジャ成形システムを完成した。
IC、LSI、LEDなどの半導体製品は、回路基板に装着された半導体チップが封止樹脂によって覆われているという構造を持っている。その封止樹脂を形成する際に使用される樹脂封止装置の心臓部が成形用金型である。成形用金型には、樹脂材料が供給される空間であるポット、樹脂材料を押圧するピストン状部材のプランジャ、溶融した樹脂材料が流れる通路のランナ、溶融樹脂が充塡されて硬化する空間であるキャビティが設けられている。従来の成形用金型には、1個の大きなポットと多数のキャビティ、それらを結ぶ長いランナが設けられていた。しかしこれでは長いランナで硬化した樹脂が多量の廃棄物になるという問題や、ポットと各キャビティとの間の距離が異なることからキャビティ同士の間で成形条件が一定せず、均一で高品質の半導体製品の製造が困難であるという問題があった。これらの問題を解決するために開発されたのがマルチプランジャ成形システムである。
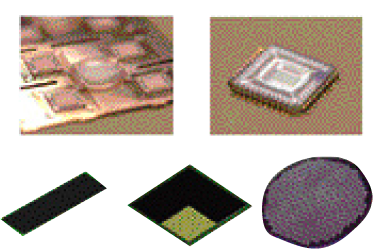 マルチプランジャ方式の成形用金型は、小さな複数個のポットとポットに隣接した複数のキャビティ、それらを連結する短いランナで構成され、従来の成形用金型が持っていた欠点を見事に解決した。この金型を核とする成形システムは、半導体パッケージの高品質化を可能にし、生産効率を飛躍的に高めたことで、各国の半導体メーカーに広く採用され、事実上の業界標準になった。またこの成形システムの成功は、TOWA株式会社が精密金型メーカーから半導体製造装置メーカーへの変貌を遂げるきっかけともなったのである。
マルチプランジャ方式の成形用金型は、小さな複数個のポットとポットに隣接した複数のキャビティ、それらを連結する短いランナで構成され、従来の成形用金型が持っていた欠点を見事に解決した。この金型を核とする成形システムは、半導体パッケージの高品質化を可能にし、生産効率を飛躍的に高めたことで、各国の半導体メーカーに広く採用され、事実上の業界標準になった。またこの成形システムの成功は、TOWA株式会社が精密金型メーカーから半導体製造装置メーカーへの変貌を遂げるきっかけともなったのである。




